公众号记得加星标⭐️,第一时间看推送不会错过。
近年来,随着芯片制程工艺不断向前演进,“摩尔定律”的迭代进度逐渐放缓。曾经依靠制程迭代实现晶体管密度翻倍、性能提升的传统路径,如今受限于物理极限与成本激增的双重挑战,单纯依赖制程突破的发展模式渐显乏力。
在此背景下,半导体行业开始积极探索“后摩尔时代”的破局方向,先进封装技术凭借独特价值迅速成为业界焦点。尤其是随着AI芯片对超高算力、低延迟的迫切需求,以及Chiplet异构集成技术的兴起,先进封装不再只是芯片的“保护壳”,更成为实现系统级性能跃升的关键载体。
与传统的封装技术相比,先进封装技术具有灵活性强、集成密度高、尺寸小、性能好等优势,主要包括倒装芯片封装、晶圆级封装、系统级封装和2.5D、3D封装等技术。
据Yole Group预测,2030年全球先进封装市场规模将突破794亿美元,2024-2030年复合年增长率(CAGR)达9.5%,AI与高性能计算需求成为拉动复苏的首要动能。市场潜力之下,行业厂商争相布局,推动先进封装赛道成为驱动产业变革的新引擎。
代工三巨头,鏖战先进封装
在先进封装这一关键赛道,台积电、英特尔、三星等厂商作为先进封装领域的关键玩家,凭借完善的技术体系化布局,占据了全球高端封装市场主导地位,形成了各具特色的竞争路径。
台积电“两手抓”,主导先进封装赛道
当前,台积电凭借CoWoS、InFO和SoIC三大核心技术构建了覆盖全场景的“3D Fabric”先进封装平台,在全球高端封装产能中占据主导地位。
其中,CoWoS作为台积电2.5D封装的核心技术,通过硅中介层集成多颗芯片,利用微凸块和硅穿孔等高密度互连技术显著提升带宽与能效。
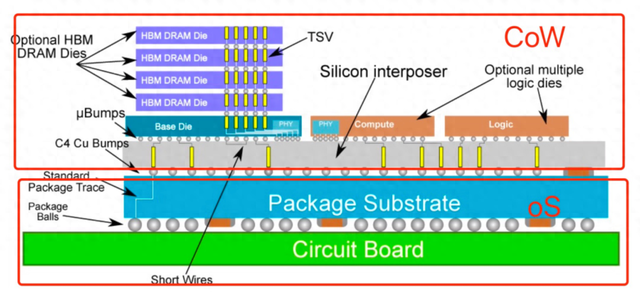
台积电CoWoS结构示意图
台积电根据不同的中介层(interposer)将“CoWoS”封装技术分为三种类型:
CoWoS_S:该类型使用Si衬底作为中介层,是2011年开发的第一个CoWoS技术;
CoWoS_R:使用重新布线层(RDL)作为中介层;
CoWoS_L:使用小芯片(Chiplet)和RDL作为中介层,结合了CoWoS-S和InFO技术的优点,具有灵活的集成性。
经过多年发展,CoWoS封装技术目前已迭代到了第5代。CoWoS-S5技术支持8颗HBM3内存与2颗SoC芯片的高密度集成,突破性地将中介层面积拓展至2400mm²,为 NVIDIA H100 GPU提供高达5.3TB/s的内存带宽,较前代技术性能提升3倍。在工艺精度层面,CoWoS-S5采用混合键合技术,将键合间距缩小至1μm,使得I/O密度达到惊人的120万/平方毫米,较传统微凸块技术提升70倍,显著增强芯片间互连效率,有效降低信号延迟与功耗,为下一代高性能计算芯片的发展奠定坚实基础。
针对成本敏感型应用,台积电开发了去中介层化的InFO技术,通过高密度RDL直接互连实现低成本、薄型化封装,这也是InFO技术在移动应用和HPC市场成功的重要原因,为台积电后来能独占苹果A系列处理器打下了关键基础。未来,随着RDL微缩化和3D堆叠技术的成熟,InFO将进一步渗透高性能计算领域,与CoWoS形成互补技术生态。
在3D封装前沿,台积电推出的SoIC技术采用晶圆对晶圆(WoW)混合键合方案,实现了真正的3D芯片堆叠。
SoIC能提供创新的前段3D芯片堆叠技术,用于重新集成从SoC划分的小芯片,最终的集成芯片在系统性能方面优于原始SoC,并且它还提供了集成其他系统功能的灵活性。相较2.5D封装方案,SoIC的凸块密度更高,传输速度更快,功耗更低。
综合来看,在先进封装领域,台积电的领先地位尤其突显。在先进制程以及先进封装中,台积电时刻保持“两手抓”的状态,以巩固自身在晶圆制造领域的霸主地位。
英特尔:EMIB+Foveros聚焦异构集成
英特尔作为IDM与晶圆代工大厂,也正在积极布局2.5D/3D先进封装技术,以EMIB和Foveros为核心构建异构集成能力,瞄准高性能计算与AI芯片市场。
在2.5D封装方面,英特尔的EMIB技术通过硅桥连接裸片,避免使用硅中介层,实现高带宽互连。其最新推出的EMIB-T技术引入TSV通孔供电,支持HBM4集成,信号传输速度达32Gb/s,兼容UCIe 2.0协议,可满足AI系统多芯片互联需求。

在3D封装领域,Foveros技术实现不同工艺、功能芯片的垂直堆叠,提供高度灵活性,支持设计人员混合搭配各类芯片模块,在提升性能的同时降低功耗。
从英特尔的先进封装技术发展路线图能看到,其先进封装主要关注互连密度、功率效率和可扩展性三个方面。从Foveros到混合键合技术,英特尔逐渐实现凸点间距越来越小,使系统拥有更高的电流负载能力、更好的热性能。
此外,英特尔在玻璃封装和CPO(共封装光学)领域也在积极探索。
其中,英特尔将玻璃封装视为先进封装核心方向,2023年已展示了首款功能齐全的玻璃封装测试芯片,该技术可与Foveros Direct等先进封装技术结合,并兼容EMIB-T架构,支撑超大型封装及光学组件集成,计划2025-2030年实现量产,还联合行业厂商探索电光玻璃基板在400G及以上集成光学方案中的应用。
在CPO领域,英特尔依托EMIB技术构建CPO架构,将XPU与光学I/O芯片通过硅桥互连,搭配定制光纤阵列单元(FAU),采用有源耦合工艺降低损耗。
三星押注先进封装,加速突围
在先进封装领域,三星围绕不同应用场景与技术需求,构建了多维度技术布局并推进落地。
其中,三星电子以I-Cube和X-Cube为核心的技术体系,分别覆盖2.5D和3D IC封装领域。I-Cube技术细分为I-Cube S、I-Cube E以及衍生的H-Cube三种方案,通过不同的中介层设计满足多样化需求。
I-Cube S采用硅中介层作为核心连接载体,将逻辑芯片与HBM裸片水平集成在同一中介层上,实现高算力、高带宽数据传输与低延迟特性。该技术优势体现在三大方面:一是在大尺寸中介层下仍能保持出色的翘曲控制能力;二是具备超低信号损失和高存储密度特性;三是显著优化了热效率控制。从结构上看,I-Cube S与台积电的CoWoS-S技术相似,均采用“芯片-硅转接板-基板”的三层架构,适用于对性能要求严苛的高端AI芯片场景。
I-Cube E采用“嵌入式硅桥+RDL中介层”的混合架构:在高密度互连区域部署硅桥以实现精细布线,其余区域则通过无硅通孔(TSV)结构的RDL中介层完成连接。这种设计既保留了硅桥的精细成像优势,又发挥了RDL中介层在大尺寸封装中的灵活性。该技术与台积电的CoWoS-L架构相近,借鉴了英特尔EMIB技术的核心思路,在平衡性能与成本方面更具优势。
H-Cube则是基于“硅中介层-ABF基板-HDI基板”的混合结构,通过将精细成像的ABF基板与高密度互连(HDI)基板结合,H-Cube可支持更大的封装尺寸,布线密度较基础版I-Cube S进一步提升。
不过从技术演进来看,H-Cube更偏向过渡性方案——随着HDI基板布线能力的提升,ABF基板的中间层未来可能被省略,因此三星未将其作为独立技术类别,而是归入I-Cube体系下。
针对3D IC封装,三星推出了X-Cube技术,通过TSV实现芯片间的垂直电气连接,显著提升系统集成度。根据界面连接方式的不同,X-Cube分为两种类型:
两种方案结构框架一致,核心差异在于连接精度与性能表现,共同构成三星在3D封装领域的技术储备。
此外,依托自身在存储领域的优势,三星推出SAINT技术体系,聚焦存储芯片与逻辑芯片的协同封装,通过创新3D堆叠方案,构筑独特竞争力。目前细分为三大针对性方案:
SAINT-S:专为SRAM设计的堆叠技术,优化静态随机存取存储器的集成效率;
SAINT-L:面向逻辑芯片的堆叠方案,提升逻辑电路的垂直集成密度;
SAINT-D:针对HBM内存与逻辑芯片的协同设计,采用垂直堆叠架构,将HBM芯片直接堆叠在CPU或GPU等处理器顶部。
值得强调的是,SAINT-D技术彻底改变了传统2.5D封装中通过硅中介层水平连接HBM与GPU的模式。它采用热压键合(TCB)工艺实现HBM的12层垂直堆叠,成功消除了对硅中介层的依赖,不仅简化了结构,更带来显著性能提升。
通过SAINT技术体系的构建,三星有望进一步强化了存储与逻辑芯片的协同封装能力,为AI、高性能计算等领域提供了更高效率、更低功耗的集成解决方案,也为其在先进封装赛道的竞争增添了关键筹码。
三星加码SoP技术,挑战台积电霸权
在先进封装技术的下一代竞争中,三星电子还正在全力推进“SoP(System on Panel,面板级系统)”技术的商业化落地,直接对标台积电的SoW和英特尔的EMIB工艺,争夺下一代数据中心级AI芯片的制高点。
作为三星差异化竞争的核心抓手,SoP技术的核心创新在于采用415mm×510mm的超大尺寸长方形面板作为封装载体,这一尺寸远超传统12英寸晶圆的有效利用面积。传统晶圆级封装受限于圆形晶圆形态,最大可集成的矩形模块尺寸约为210mm×210mm,而三星SoP面板可轻松容纳两个此类模块,甚至能生产240mm×240mm以上的超大型半导体模块,为超大规模AI芯片系统提供了更大的集成空间。
技术架构上,SoP省去了传统封装所需的PCB和硅中介层,通过精细铜RDL实现芯片间的直接通信。这种设计不仅提升了集成度,还能降低封装成本,尤其适配AI芯片和数据中心高性能计算场景的需求。三星在面板级封装领域积累的FOPLP技术经验,为SoP的研发提供了坚实基础。
三星对SoP技术的押注,本质上是一场“错位竞争”:在台积电凭借CoWoS垄断高端AI芯片封装、英特尔依托EMIB抢占HPC市场的当下,通过SoP的尺寸与成本优势,打破现有技术格局,重塑先进封装市场的竞争逻辑。若SoP技术成功量产,不仅能补齐三星“设计-制造-封装”一体化服务的最后一块短板,更能强化其客户绑定能力——此前三星已斩获特斯拉165亿美元AI6芯片代工订单,若SoP技术成熟,有望将封装环节也纳入合作范围。
先进封装,国产厂商从跟跑到并跑?
在国际头部厂商主导高端封装市场的同时,国内封测企业也正以“技术攻坚+产业链协同”为路径,加速在先进封装领域实现从跟跑到并跑的突破。
据Yole数据,2024年中国先进封装市场规模达698亿元,同比增长18.7%,以长电科技、华天科技、通富微电等为代表的国产先进封装龙头企业贡献了核心增长动能,依托国内芯片设计产业需求,正通过技术突破和产能扩张,在2.5D/3D封装、Chiplet集成等关键领域持续发力,成为国内半导体产业链补链强链的重要力量。
长电科技:国产先进封装“领头羊”
作为国内封测市占率第一的企业,长电科技2025年上半年实现营业收入186.05亿元,同比增长20.14%,在汽车电子、高性能计算等高端应用领域表现突出。
长电科技以自主开发的“XDFOI Chiplet平台”为核心基础,构建了一套覆盖2.5D、3D等多维异构集成场景的先进封装体系。该平台采用Fan-Out封装技术,集成高密度RDL和µBump等关键工艺,支持多颗Chiplet芯片在有机基板上实现高带宽、低延迟的互连。通过引入薄型化中介层和局部硅桥技术,XDFOI平台可在封装内部实现50µm以下厚度的中介层与40µm微凸点间距,显著提升系统集成密度与散热性能,广泛应用于高性能计算、人工智能加速器和高端网络芯片等领域,目前已进入稳定量产阶段,成为支撑先进制程延续和异质集成的重要解决方案。
长电科技的技术布局广泛而深入。2025年上半年在玻璃基板、CPO光电共封装、大尺寸FCBGA等关键技术上也取得了突破性进展。此外,在半导体封装结构领域,长电科技还公布了“半导体封装结构及其形成方法”专利,提高了玻璃基板上表面的第一互连结构的布线密度。
市场布局方面,长电科技2025年上半年汽车电子业务同比增长34.2%,工业及医疗领域同比增长38.6%。其位于上海临港的车规芯片封装测试工厂已完成主体建设并进入内部装修阶段,投产准备工作有序推进。
通富微电:
深度绑定头部客户的技术领先者
通富微电凭借与AMD的深度合作关系,在AI和HPC领域的先进封装布局具有独特优势。2025年上半年,公司实现营业收入130.38亿元,同比增长17.67%,实现归母净利润4.12亿元,同比增长27.72%。
技术方面,通富微电在大尺寸FCBGA开发方面取得重要进展,其中大尺寸FCBGA已进入量产阶段,超大尺寸FCBGA已预研完成并进入正式工程考核阶段。公司还解决了超大尺寸下的产品翘曲和散热问题。
近期,通富微电获得了一项“扇出型封装方法”发明专利授权,能够降低芯片翘曲的概率并提高扇出型器件的散热效果。今年以来,通富微电新获得专利授权18个,较去年同期增加了28.57%。同时,在玻璃基板先进芯片封装技术方面,通富微电也取得了重要进展,基于玻璃基板的先进芯片封装技术已成功通过阶段性可靠性测试。
此外,通富微电还依托与国内头部芯片设计公司的深度协同,实现CPU与AI加速芯粒的互联,在Chiplet与先进测试领域形成特色优势。
通富微电与国内大厂的合作,在证明其技术实力的同时,也标志着中国半导体从“追赶制程”转向“封装破局”。通过Chiplet技术将成熟制程芯粒高密度集成,在算力层面实现对国际巨头的弯道超车,为AI、服务器等高端芯片国产化提供关键技术支撑
华天科技:专注自研的追赶者
华天科技正通过大力研发投入和产能扩张,加速在先进封装领域的布局。2025年上半年,公司开发完成ePoP/PoPt高密度存储器及应用于智能座舱与自动驾驶的车规级FCBGA封装技术,2.5D/3D封装产线完成通线。
2025年8月,华天科技宣布设立子公司南京华天先进封装有限公司,主营2.5D/3D等先进封装测试业务,这一举措显示了其抢占高端市场的决心。
此外,华天科技在CPO封装技术领域也取得进展。据报道,其CPO封装技术关键单元工艺开发正在进行之中。同时,其FOPLP封装完成多家客户不同类型产品验证,已通过客户可靠性认证。
市场拓展方面,华天科技的汽车电子和存储器订单大幅增长,聚焦先进封装技术突破与产能扩张,为高性能计算、人工智能及车载芯片提供关键支持。
此外,还有厦门云天半导体、湖南越摩先进半导体与合肥矽迈微电子等诸多国内企业聚焦先进封装赛道,为行业发展助力赋能,分别在晶圆级封装、系统级集成与基板级扇出技术方面形成了差异化布局。
据了解,云天半导体聚焦晶圆级三维封装(WLP)、扇出型封装及TGV转接板等前沿工艺,具备多尺寸晶圆制造能力,服务射频、生物医疗等高附加值领域;越摩半导体依托深厚技术积累,提供从设计仿真到量产的SiP、fcBGA、Chiplet等先进封装解决方案,覆盖高性能计算、汽车电子等多元市场;矽迈微电子则凭借自主专利建成国内首条基板扇出型封装产线,在CSP、QFN、SIP等封装形态上实现高集成、高可靠性产品落地。
从整体发展态势来看,国内封测企业立足各自聚焦的细分赛道,在优势领域持续深耕突破,以“多点发力、协同共进”的态势,共同驱动中国半导体先进封装技术的自主创新升级与产业规模化应用落地。
湾芯展2025,
国产先进封装技术“秀肌肉”
在全球先进封装技术快速演进、市场格局深刻变革的背景下,2025湾区半导体产业生态博览会(湾芯展)将于10月15-17日在深圳会展中心(福田)隆重举办。本届展会将聚焦先进封装赛道,成为洞察全球封装技术趋势的重要窗口。
湾芯展既是封装企业展示创新成果与新品的舞台,也是全球行业领袖与专家共商市场前景与发展策略的高端平台。在先进封装领域,华天科技、云天半导体、天芯互联、越摩先进半导体、矽迈微电子等代表性企业将齐聚现场,集中展现其在Chiplet、晶圆级封装、2.5D/3D封装、系统集成等方向的技术实力与最新突破。
同期举办的先进封装论坛将围绕先进封装工艺与材料、Chiplet与异构集成、光电芯片等热点议题展开深度探讨。来自全球的行业精英与学者将分享见解,推动产业链协同与技术突破。
对国产封测企业而言,湾芯展是展示自身实力的重要契机。展会也将聚焦中国半导体市场复苏、AI算力芯片需求增长等关键议题,为企业把握风向、布局未来提供前瞻指引。
半导体行业观察&湾芯展
边缘AI赋能硬件未来创新论坛
2025.10.15
深圳会展中心(福田)
9:00-9:50
观众签到入场
9:50-10:00
开幕致辞
深芯盟
执行秘书长 张建
10:00-10:20
面向个人智能体的端侧大模型芯片
深港微电子学院
副院长 余浩教授
10:20-10:40
释放端侧AI潜力,NPU助力开启硬件创新“芯”时代
安谋科技 Arm China
产品总监 鲍敏祺
10:40-11:00
打造智算时代的新质生产力
深圳云天励飞技术股份有限公司
副总裁 罗忆
11:00-11:20
AI赋能,扬帆出海
中国联通
总监 杨程
11:20-11:40
海外云计算与AI应用的made in china情怀
浪潮云
高级战略总监 张晟彬
11:40-12:00
创新 RISC-V 架构——铸建新一代智算未来
阿里巴巴达摩院(杭州)科技有限公司
商务拓展负责任人 李珏
12:00-13:30
午休&抽奖
13:30-13:50
中国电信国际公司大湾区市场洞察
中国电信
信息科技客户部总经理 张黎明
13:50-14:10
AI新时代下的“通推一体”处理器
知合计算技术(上海)有限公司
首席科学家 苏中
14:10-14:30
大模型部署的规模化实践
魔形智能科技(上海)有限公司
创始人 金琛
14:30-14:50
光计算系统重构智算基建新范式
光本位智能科技(上海)有限公司
产品与市场副总裁 姚金鑫
14:50-15:10
联想凌拓半导体行业高效存储解决方案
联想凌拓科技有限公司
半导体部总经理 余晓丹
15:10-15:30
预见未来:大模型+工程智能赋能半导体未来工厂“制造革命”
深圳智现未来工业软件有限公司
副总裁 朱军
15:30-15:50
AI芯片测试技术发展与挑战
工业和信息化部电子第五研究所
副主任 王之哲
15:50-16:20
圆桌&抽奖
**最终议程以现场为主
结语
据预测,2025年全球先进封装市场规模预计达到569亿美元,首次超过传统封装,2028年或能达到786亿美元。
在此行业趋势和复杂的国际贸易关系背景下,国产替代成为国内封测企业发展的重大机遇。封测作为中国大陆在半导体产业的强势环节,头部厂商在中高端先进封装市场已占据一定份额。
未来,随着本土AI算力芯片蓬勃发展,自主可控趋势下高端先进封装迎来发展机会。
国内产业链相关厂商通过全面布局、深度绑定和技术专注——正逐步缩小与国际头部的差距,在全球半导体版图上争夺更多话语权。它们的共同目标是:为“后摩尔时代” 国内半导体产业链自主可控提供关键支撑,为中国半导体产业赢得下一个十年。
*免责声明:本文由作者原创。文章内容系作者个人观点,半导体行业观察转载仅为了传达一种不同的观点,不代表半导体行业观察对该观点赞同或支持,如果有任何异议,欢迎联系半导体行业观察。
END
今天是《半导体行业观察》为您分享的第4184期内容,欢迎关注。
★
★
★
★
★
★
★
★
加星标⭐️第一时间看推送,小号防走丢

求分享

求推荐







发表评论